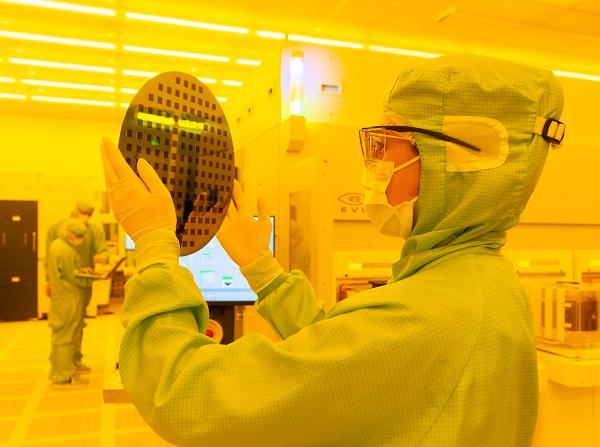
EVG는 인공지능(AI) 가속기와 고성능 컴퓨팅(HPC)의 핵심 구성요소인 HBM(high-bandwidth memory) 및 3D DRAM의 개발 과 생산을 지원하는 TB/DB 솔루션을 포함하여, 업계에서 가장 포괄적인 웨이퍼 본딩 솔루션을 제공한다.
세미콘 코리아는 미래를 만들어 나가는 핵심 트렌드를 선보이는 세계 최고의 반도체 기술 전시회 중 하나로, 올해 행사에서는 AI와 함께 첨단 패키징, 지속 가능한 반도체 제조 등이 주요 주제로 다뤄질 전망이다.
EVG 아태지역 세일즈 디렉터인 토르스텐 마티아스 박사(Dr. Thorsten Matthias)는 “차세대 HBM 과 3D DRAM의 개발 및 양산을 가속화하는 것은 한국 반도체 업계의 최우선 과제이며, 이는 TB/DB기술의 혁신을 필요로 한다”며, “EVG의 IR LayerRelease 기술을 적용하면 더 얇은 두께의 다이를 구현함으로써 HBM을 더 높이 적층할 수 있기 때문에, 기계적 디본딩의 필요성을 없애 준다. 또한 IR LayerRelease는 실리콘 캐리어 사용을 지원하면서 기계적 디본딩 공정을 1:1 대체하여, 현재 및 차세대 적층 메모리 공정을 모두 지원한다. 뿐만 아니라 프런트엔드 호환성을 제공하므로 퓨전 및 하이브리드 본딩 공정과도 결합할 수 있어 차세대 메모리 및 비메모리 반도체에 필수적인 초박형 웨이퍼 및 필름 프로세싱에도 이상적이다”라고 설명했다.
TBDB는 이러한 첨단 메모리 칩 제조에 필수적인 칩 적층 공정 중에 핵심이다. 기계적 디본딩과 같은 기존의 디본딩 방식은 차세대 HBM과 같이 매우 복잡한 설계의 초박형 웨이퍼를 위한 충분한 정밀도를 제공하지 못한다. EVG의 IR LayerRelease 솔루션은 정밀성, 더 높은 수율, 더 낮은 소유 비용, 환경에 대한 영향, 그리고 미래 대응 능력 측면에서 한국을 비롯한 전세계 메모리 반도체 및 기타 디바이스 제조사들에게 명확한 이점을 제공한다.
IR LayerRelease는 기존의 기계적 디본딩을 대체하며, EVG®850 플랫폼을 기반으로 하는 EVG의 슬라이드 오프 및 UV 레이저 디본딩 솔루션들과 함께 EVG 디본딩 기술 포트폴리오를 더욱 강화한다.
©'5개국어 글로벌 경제신문' 아주경제. 무단전재·재배포 금지



![[르포] 중력 6배에 짓눌려 기절 직전…전투기 조종사 비행환경 적응훈련(영상)](https://image.ajunews.com/content/image/2024/02/29/20240229181518601151_258_161.jpg)



