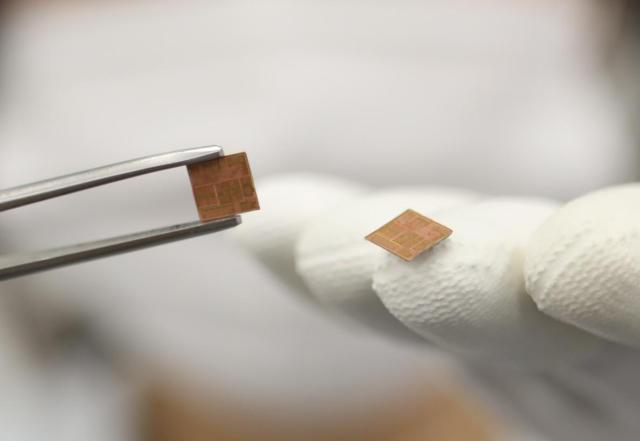
LG이노텍은 모바일용 고부가 반도체 기판에 적용되는 '코퍼 포스트(구리 기둥) 기술'을 세계 최초로 개발하고, 이를 양산 제품에 적용하는 데 성공했다고 25일 밝혔다.
주요 스마트폰 제조사들이 슬림화 경쟁에 뛰어들며 스마트폰 부품 크기 최소화가 업계 화두다. 이에 RF-SiP(Radio Frequency-System in Package) 기판 등 모바일용 반도체 기판의 성능을 고도화하면서도 크기는 최소화할 수 있는 기술 수요가 급증하고 있다.
LG이노텍은 이러한 스마트폰 트렌드를 예측하고, 2021년부터 선제적으로 차세대 모바일용 반도체 기판 기술인 '코퍼 포스트'를 개발해왔다.
이 기술은 반도체 기판과 메인보드 연결 시 구리 기둥을 활용하는 것이 핵심이다. 기존 방식 대비 더 많은 회로를 반도체 기판에 배치할 수 있으며 반도체 패키지의 열 방출에도 효과적이다. 모바일 제품의 슬림화 및 고사양화에 최적화한 기술로 업계의 주목을 받고 있다.
반도체 기판은 반도체 칩, 전력 증폭기, 필터 등 전자부품을 메인보드와 연결하는 제품이다. 납땜용 구슬인 솔더볼(Solder Ball)을 통해 메인보드와 연결돼 전기신호를 주고받는다. 이 솔더볼을 촘촘히 배열할수록 더 많은 회로를 연결할 수 있으며, 이는 스마트폰 성능 향상의 핵심 요소로 꼽힌다.
LG이노텍은 기존에는 반도체 기판에 솔더볼을 직접 부착해 메인보드와 연결하는 대신, '코퍼 포스트' 기술로 구리 기둥을 먼저 세우고 그 위에 솔더볼을 작게 얹었다. 구리로 기둥을 세우는 것은 업계에서 고난도 기술로 알려져 있다.
이 기술로 LG이노텍은 솔더볼 간격을 기존 대비 약 20% 가까이 줄이는 데 성공했다. 기둥 구조를 통해 솔더볼의 면적과 크기를 최소화했으며, 녹는점이 높은 구리를 사용해 고온 공정에서도 기둥 형태가 안정적으로 유지돼 더욱 촘촘한 배열 설계가 가능해졌다.
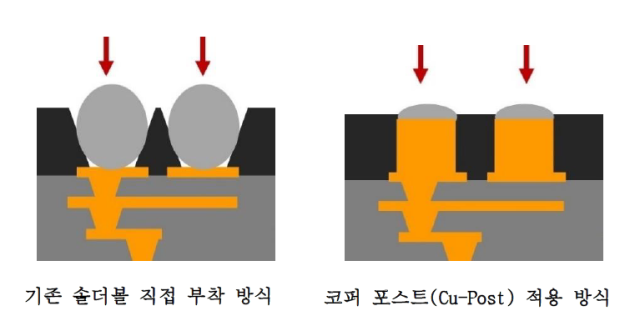
LG이노텍의 코퍼 포스트 기술을 적용하면 기존과 동일한 성능을 구현하면서도 크기는 최대 20%가량 작은 반도체 기판을 만들 수 있다. 스마트폰 제조사는 설계 자유도를 높이고 디자인 슬림화가 가능하다.
또한 이 기술은 복잡하고 방대한 전기신호를 효율적으로 처리해야 하는 인공지능(AI) 연산 등 스마트폰의 고사양 기능에 최적화됐다. 같은 크기의 반도체 기판이라면 기존 대비 더 많은 솔더볼을 배치하고 기판 회로 수를 늘릴 수 있다. 회로 밀도를 높인 고성능 반도체 기판 설계가 가능한 이유다.
스마트폰 발열도 개선할 수 있다. '코퍼 포스트'에 사용된 구리는 납 대비 열전도율이 7배 이상 높아 반도체 패키지에서 발생하는 열을 보다 빠르게 외부로 방출한다. 열에 의한 칩 성능 저하나 신호 손실 등 문제를 최소화해 모바일 기기의 성능을 안정적으로 유지할 수 있다.
문혁수 LG이노텍 대표는 "이 기술은 단순한 부품 공급 목적이 아닌 고객의 성공을 지원하기 위한 깊은 고민에서 나온 것"이라며 "혁신 제품으로 기판 업계의 패러다임을 바꾸며 차별적 고객가치를 지속 창출해 나가겠다"고 말했다.
©'5개국어 글로벌 경제신문' 아주경제. 무단전재·재배포 금지



![[르포] 중력 6배에 짓눌려 기절 직전…전투기 조종사 비행환경 적응훈련(영상)](https://image.ajunews.com/content/image/2024/02/29/20240229181518601151_258_161.jpg)



